| 営業時間は10:00~19:00となっております。 | |
| (土曜、日曜日にも営業、定休日:毎週火曜日) | |
| 電 話 | 043-216-4278(10:00~19:00) |
|---|---|
| メール | support@pcaie.jp(年中無休24時間対応) |
| 営業時間は10:00~19:00となっております。 | |
| (土曜、日曜日にも営業、定休日:毎週火曜日) | |
| 電 話 | 043-216-4278(10:00~19:00) |
|---|---|
| メール | support@pcaie.jp(年中無休24時間対応) |
BGAのリボール、試作をお任せください。
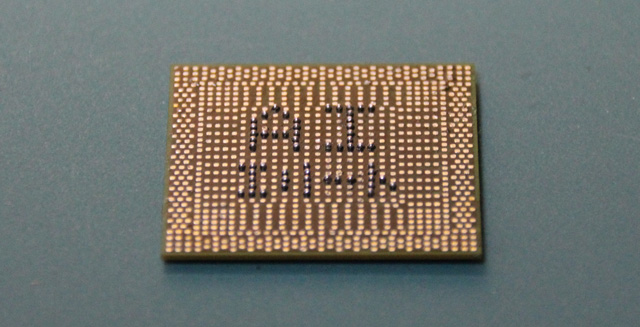
パッケージ底面の格子状に並んだ端子へディスペンサで溶けた半田を塗布し、半田の表面張力で半球状に形成された電極(バンプともいう)を持つ。表面実装で、リフロー炉ではんだ付けをする時に使われる。手作業による半田付けは不可能である。 QFPと比較して多数の電極を設けることが出来る上、周囲にリードが張り出さないので実装面積を縮小できる。ただし、外部からはんだ付けの状態を検査するのが困難となる。 また、一度はんだ付けしてしまうと部分的な修正や交換は専用の設備を持つ工場でもかなり困難である。取り外す時に基板を再加熱する必要があるため、多層構造の基板や後工程ですでに実装されている部品の耐熱規格によっては修理できない場合もある。外されたBGAに再びバンプを付けるのも、専用工具が必要な上に難易度が高い。 パッケージの熱膨張率と基板の熱膨張率が異なることから、通電中に発熱する素子の場合、電源投入と電源断を反復することによって熱膨張と収縮が繰り返され基板またはパッケージが歪み、はんだ付けされた接点にクラックが発生する可能性が高い。 ソケットによる実装は通常しないが、開発用途としてのソケットは存在する。 TBGA(Tape Ball Grid Array) と呼ばれる、TAB技術によるフレキシブル基板をサブストレートに使用したBGAも存在する。
Wikipediaより